삼성전자, 차세대 반도체 패키지 기술 'I-Cube4' 개발
독자 2.5D 패키지 솔루션
로직과 HBM 4개 한 패키지에 구현…하나의 반도체처럼 동작
고성능 컴퓨팅·AI 등에 활용…데이터 처리 속도 높여
[아시아경제 김흥순 기자] 삼성전자 삼성전자 close 증권정보 005930 KOSPI 현재가 270,500 전일대비 25,500 등락률 -8.61% 거래량 38,075,487 전일가 296,000 2026.05.15 15:30 기준 관련기사 '팔천피'의 저주인가…뚫자마자 추락하더니 7400선 마감, 코스닥도 5% 빠져 코스피, 외국인 '팔자'에 장중 7600선까지 하락 "삼성그룹 노조 '영업익 연동 성과급 요구', 주식회사 법리 위배" 는 컴퓨터 중앙처리장치(CPU)·그래픽처리장치(GPU) 등의 로직 칩과 고대역폭 메모리(HBM) 칩을 하나로 묶은 차세대 반도체 패키지 기술 ‘아이큐브(I-Cube)4’를 개발했다고 6일 밝혔다.
I-Cube는 삼성전자 삼성전자 close 증권정보 005930 KOSPI 현재가 270,500 전일대비 25,500 등락률 -8.61% 거래량 38,075,487 전일가 296,000 2026.05.15 15:30 기준 관련기사 '팔천피'의 저주인가…뚫자마자 추락하더니 7400선 마감, 코스닥도 5% 빠져 코스피, 외국인 '팔자'에 장중 7600선까지 하락 "삼성그룹 노조 '영업익 연동 성과급 요구', 주식회사 법리 위배" 의 독자적인 2.5D 패키지 솔루션 브랜드다. 2.5D 패키지는 '인터포저(인쇄회로 기판과 칩 사이에서 막 역할을 하는 기능성 패키지판)'를 이용해 CPU·GPU등의 로직 칩과 HBM을 1개의 패키지 안에 배치하는 기술로 I-Cube 뒤에 붙는 숫자 '4'는 HBM 칩을 4개 넣었다는 뜻이다. 여러 개의 칩을 패키지 하나에 담아 데이터 처리 속도를 빠르게 하고, 제품 내부에서 패키지가 차지하는 면적을 줄이는데 효과적이다.
삼성전자 삼성전자 close 증권정보 005930 KOSPI 현재가 270,500 전일대비 25,500 등락률 -8.61% 거래량 38,075,487 전일가 296,000 2026.05.15 15:30 기준 관련기사 '팔천피'의 저주인가…뚫자마자 추락하더니 7400선 마감, 코스닥도 5% 빠져 코스피, 외국인 '팔자'에 장중 7600선까지 하락 "삼성그룹 노조 '영업익 연동 성과급 요구', 주식회사 법리 위배" 는 "고대역폭 데이터 전송과 고성능 시스템 반도체를 요구하는 고성능 컴퓨팅(HPC)을 비롯해 인공지능(AI)·클라우드 서비스, 데이터센터 등을 중심으로 I-Cube4가 폭넓게 활용될 것으로 기대한다"고 전했다.
반도체 제조는 실리콘으로 된 기판(웨이퍼)에 미세 회로를 그리는 '전공정'과 웨이퍼를 제작한 뒤 이뤄지는 테스트, 절단, 패키징 등의 '후공정'으로 나뉜다. I-Cube처럼 여러 기능을 가진 반도체를 하나로 엮는 기술은 후공정 중에서도 첨단 패키징 작업으로 분류된다.
기존에는 D램이나 낸드플래시, 로직, 영상변환반도체(CIS) 등 각각 고유의 성능을 지닌 단품 형태의 반도체 제조 경쟁이 주를 이뤘다. 그러나 4차산업혁명이 도래하면서 AI, 자율주행, 사물인터넷(IoT), HPC, 웨어러블 등 반도체를 사용하는 플랫폼이 다양해지고 패키징 기술을 포함한 후공정의 중요성도 부각되고 있다.
실리콘 인터포저 적용…안정적 전력 공급·초미세 배선 구현
열 방출 성능 우수한 구조
"I-Cube6·I-Cube8 개발 예정"
글로벌 반도체 시장에서 I-Cube처럼 복수의 칩을 1개의 패키지에 집적하는 2.5D 기술을 보유한 업체는 대만 TSMC와 삼성전자 삼성전자 close 증권정보 005930 KOSPI 현재가 270,500 전일대비 25,500 등락률 -8.61% 거래량 38,075,487 전일가 296,000 2026.05.15 15:30 기준 관련기사 '팔천피'의 저주인가…뚫자마자 추락하더니 7400선 마감, 코스닥도 5% 빠져 코스피, 외국인 '팔자'에 장중 7600선까지 하락 "삼성그룹 노조 '영업익 연동 성과급 요구', 주식회사 법리 위배" 정도로 알려졌다. 앞서 삼성전자는 2018년 로직과 HBM 칩 2개를 집적한 'I-Cube2' 솔루션을 선보였고, 지난해에는 로직과 캐시메모리(SRAM·자주 사용하는 작업이나 동작을 저장해두는 임시 기억공간)를 수직으로 쌓은 '엑스큐브(X-Cube)' 기술을 공개하는 등 차세대 패키지 기술에도 공을 들이고 있다.
I-Cube4는 I-Cube2보다 HBM 칩 개수가 2개 많아 보다 넓은 인터포저가 필요하다. 대개 면적이 증가하면 쿠킹포일이 말리는 것처럼 인터포저가 휘는 현상이 발생하는데 삼성전자는 A4용지 1장보다 얇은 100㎛ 수준까지 인터포저가 변형되지 않는 기술을 개발해냈다.
또 실리콘 소재의 인터포저를 적용해 초미세 배선을 구현하고 반도체 구동에 필요한 전력을 안정적으로 공급할 수 있도록 했다. 습기, 진동, 충격으로부터 칩을 보호하기 위해 사용하는 열경화성 수지(몰드)가 필요치 않은 독자적인 구조도 적용해 열을 보다 효율적으로 방출할 수 있다고 삼성 측은 설명했다.
꼭 봐야 할 주요 뉴스
 "어쩐지 타이밍 절묘하더라"…전쟁 언급하더니 뒤...
"어쩐지 타이밍 절묘하더라"…전쟁 언급하더니 뒤...
강문수 삼성전자 삼성전자 close 증권정보 005930 KOSPI 현재가 270,500 전일대비 25,500 등락률 -8.61% 거래량 38,075,487 전일가 296,000 2026.05.15 15:30 기준 관련기사 '팔천피'의 저주인가…뚫자마자 추락하더니 7400선 마감, 코스닥도 5% 빠져 코스피, 외국인 '팔자'에 장중 7600선까지 하락 "삼성그룹 노조 '영업익 연동 성과급 요구', 주식회사 법리 위배" 파운드리사업부 마켓전략팀 전무는 "고성능 컴퓨팅 분야를 중심으로 차세대 패키지 기술의 중요성이 높아지고 있다"며 "I-Cube2를 양산한 경험과 I-Cube4를 상용화한 기술 경쟁력을 기반으로 HBM을 6개·8개까지 탑재하는 신기술을 개발해 2.5D 패키지 시장에서 영역을 확장해 나갈 계획"이라고 말했다.
<ⓒ투자가를 위한 경제콘텐츠 플랫폼, 아시아경제(www.asiae.co.kr) 무단전재 배포금지>
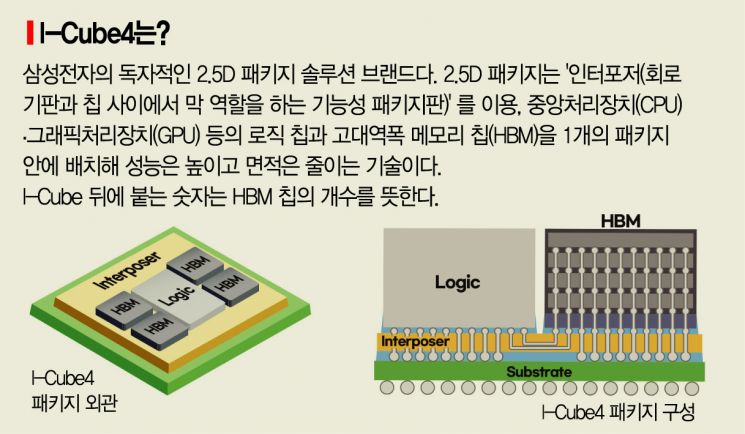
![삼성전자 차세대 반도체 패키지 기술 'I-Cube4'[사진제공=삼성전자]](https://cphoto.asiae.co.kr/listimglink/1/2021050608571222948_1620259032.jpg)










!["편의점 10곳 돌아도 못 샀다" 난리…벌써 1억개 팔린 빵 정체[지금 사는 방식]](https://cwcontent.asiae.co.kr/asiaresize/308/2026051314412961326_1778650889.jpg)


![AI 때문에 일자리 사라진다더니…구인 800% 폭증한 '이 직종' [테크토크]](https://cwcontent.asiae.co.kr/asiaresize/308/2026051413392963075_1778733569.jpg)

![[주末머니]입법지연·거래량 감소에…성장엔진 꺼진 가상자산 거래소](https://cwcontent.asiae.co.kr/asiaresize/308/2025100616485460670_1759736934.gif)
![[주末머니]"마르디 메크르디 글로벌 통했다"…K패션 대표주자 도약 시동](https://cwcontent.asiae.co.kr/asiaresize/308/2026051509485764407_1778806136.png)
![[초동시각]애물단지가 된 필리버스터](https://cwcontent.asiae.co.kr/asiaresize/308/2026051513484496581A.jpg)
![[기자수첩]'현대판 러다이트' 멈춰선 공장의 의미](https://cwcontent.asiae.co.kr/asiaresize/308/2026051513493797137A.jpg)
![[남산길 산책]2026년 아비뇽, 세계에 선보일 K-연극](https://cwcontent.asiae.co.kr/asiaresize/308/2026051513455791682A.jpg)









!["편의점 10곳 돌아도 못 샀다" 난리…벌써 1억개 팔린 빵 정체[지금 사는 방식]](https://cwcontent.asiae.co.kr/asiaresize/309/2026051314412961326_1778650889.jpg)

!["HBM도 넘본다"…삼성·SK, 中 추격에도 '초격차' 유지하려면[칩톡]](https://cwcontent.asiae.co.kr/asiaresize/309/2025021710490034501_1739756940.jpg)








