삼성, 반도체 패키징도 초격차…'12단 3D-TSV' 패키징 기술 최초 개발
기존 8단→12단 적층 기술 개발 성공
업계 최대 용량 24GB HBM 양산 예정
[아시아경제 기하영 기자] 삼성전자 삼성전자 close 증권정보 005930 KOSPI 현재가 296,000 전일대비 12,000 등락률 +4.23% 거래량 39,314,752 전일가 284,000 2026.05.14 15:30 기준 관련기사 삼성 노사 평행선 계속…사측 "직접 대화" vs 노조 "성과급 결단 없으면 파업"(종합) 외국인 2.8兆 매도 속 코스피 신고가 마감…8천피 눈앞(종합) 삼성, 노조에 "직접 대화하자" 공식 제안…사후조정 결렬에 '유감' 가 업계 최초로 '12단 3D-TSV(3차원 실리콘 관통전극·3D Through Silicon Via)' 기술을 개발했다고 7일 밝혔다. 반도체 패키징 기술 중 가장 난이도가 높은 기술로, 속도와 소비전력을 획기적으로 개선할 수 있는 점이 특징이다.
12단 3D-TSV는 기존 금선(와이어)을 이용해 칩을 연결하는 대신 반도체 칩 상단과 하단에 머리카락 굵기의 20분의 1수준인 수 마이크로미터 직경의 전자 이동 통로(TSV) 6만개를 만들어 오차 없이 연결하는 첨단 패키징 기술이다. 이 기술은 종이(100㎛)의 절반 이하 두께로 가공한 D램 칩 12개를 적층해 수직으로 연결한다.
삼성전자는 기존 8단 적층 HBM2 제품과 동일한 패키지 두께(720㎛)를 유지하면서도 12개의 D램 칩을 적층해 고객들은 별도의 시스템 디자인 변경 없이 보다 높은 성능의 차세대 고용량 제품을 출시할 수 있게 됐다.
또 고대역폭 메모리에 12단 3D-TSV 기술을 적용해 기존 8단에서 12단으로 높임으로써 용량을 1.5배 증가시킬 수 있다.
이 기술에 최신 16Gb D램 칩을 적용하면 업계 최대 용량인 24GB 고대역폭 메모리(HBM·High Bandwidth Memory) 제품도 구현할 수 있다. 이는 현재 주력으로 양산 중인 8단 8GB 제품보다 3배 늘어난 용량이다.
백홍주 삼성전자 DS부문 TSP총괄 부사장은 "인공지능, 자율주행, HPC(High-Performance Computing) 등 다양한 응용처에서 고성능을 구현할 수 있는 최첨단 패키징 기술이 날로 중요해지고 있다"며 "기술의 한계를 극복한 혁신적인 12단 3D-TSV 기술로 반도체 패키징 분야에서도 초격차 기술 리더십을 이어갈 것"이라고 말했다.
꼭 봐야 할 주요 뉴스
 텀블러에 담아 입 대고 마셨는데…24시간 지난 후...
텀블러에 담아 입 대고 마셨는데…24시간 지난 후...
삼성전자는 고객 수요에 따라 '12단 3D-TSV' 기술을 적용한 업계 최대 용량의 24GB급 고용량 HBM 제품의 양산에 돌입할 계획이다.
<ⓒ투자가를 위한 경제콘텐츠 플랫폼, 아시아경제(www.asiae.co.kr) 무단전재 배포금지>
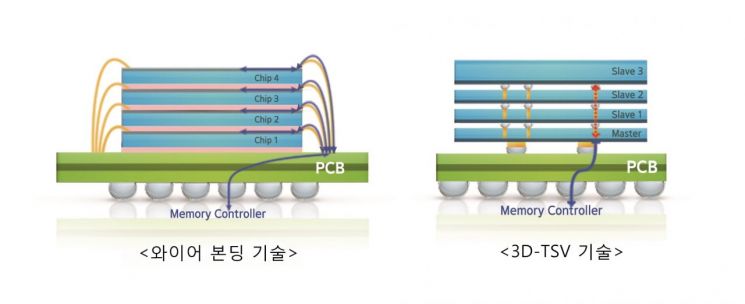
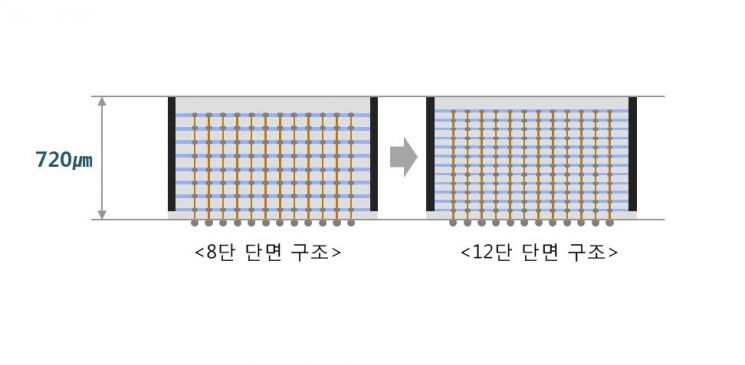


![[시시비비] 과학, 맹신, 사기… 혼돈의 딥테크 주식](https://cwcontent.asiae.co.kr/asiaresize/308/2026051407271078513A.jpg)
![[초동시각]코스피8000 시대, AI투자도 대전환 시급](https://cwcontent.asiae.co.kr/asiaresize/308/2026051409011380770A.jpg)
![[기자수첩]소상공인에겐 너무 먼 일·가정 양립](https://cwcontent.asiae.co.kr/asiaresize/308/2026051409481693494A.jpg)













![[단독]문신사법 시행 앞두고 엇갈린 법원…‘눈썹문신 무죄’ 대법 심리 착수](https://cwcontent.asiae.co.kr/asiaresize/308/2020013114494834033_1580449788.jpg)







!["10년 만에 해냈다…이번엔 진짜" 반도체 호황에 1분기 경상흑자 '사상최대'[BOK포커스]](https://cwcontent.asiae.co.kr/asiaresize/309/2026051315410261534_1778654463.png)


![[미중 정상회담]테이블에 무역휴전 연장…"45兆 상품관세 인하 논의"](https://cwcontent.asiae.co.kr/asiaresize/309/2026051411260162853_1778725560.jpg)


![[미중 정상회담]트럼프 "상호주의 더욱 발전"…시진핑 "공동이익, 분란 이겨"](https://cwcontent.asiae.co.kr/asiaresize/309/2026051411462362902_1778726783.jpg)







